最新研發的氧化鎵MOSFET耐壓超過1800V
摘要: 紐約州立大學布法羅分校(University at Buffalo) 宣布研制出擊穿電壓超過1800V的β-Ga2O3 MOSFET [Ke Zeng et al, IEEE ElectronDevice Letters, published online 23 July 2018],而在此之前的耐壓水平位于750V以下。
氧化鎵(β-Ga2O3)單晶是一種直接帶隙超寬禁帶氧化物半導體,其禁帶寬度為4.8~4.9eV,具有獨特的紫外透過特性(吸收截止邊~260nm);擊穿電場強度高達8MV/cm,是Si的近27倍、SiC及GaN的2倍以上,巴利加優值分別是SiC、GaN的10倍、4倍以上,并且可以采用熔體法生長大尺寸體單晶,因此β-Ga2O3已成為超高壓功率器件和深紫外光電子器件的優選材料之一。
紐約州立大學布法羅分校(University at Buffalo) 宣布研制出擊穿電壓超過1800V的β-Ga2O3 MOSFET [Ke Zeng et al, IEEE ElectronDevice Letters, published online 23 July 2018],而在此之前的耐壓水平位于750V以下。擊穿電壓的提高歸因于場板設計的改進,采用復合電介質支撐場板金屬。在預期的高場區域采用原子層沉積( ALD )方法沉積電介質從而提高了材料質量。
該器件是使用半絕緣摻鐵Ga2O3襯底制造的,在該襯底上先后沉積200nm厚的非故意摻雜(unintentionally doped ,UID )和摻錫( Sn )Ga2O3外延層。然后在源極/漏極區域使用旋涂玻璃技術選擇性的進行Sn摻雜。源極/漏極的接觸金屬是退火的鈦/金。柵極電介質是用ALD方法沉積的20nm厚的二氧化硅薄膜。等離子體增強化學氣相沉積( PECVD )和ALD方法沉積的二氧化硅為場板結構提供了支持。該疊層還包括薄的ALD方法沉積的氧化鋁層,該層被設計成用作柵極溝槽反應離子蝕刻的停止層。溝槽底部的氧化鋁蝕刻停止層通過濕法蝕刻去除。柵極和場板金屬由鈦/鋁/鎳/金組成。
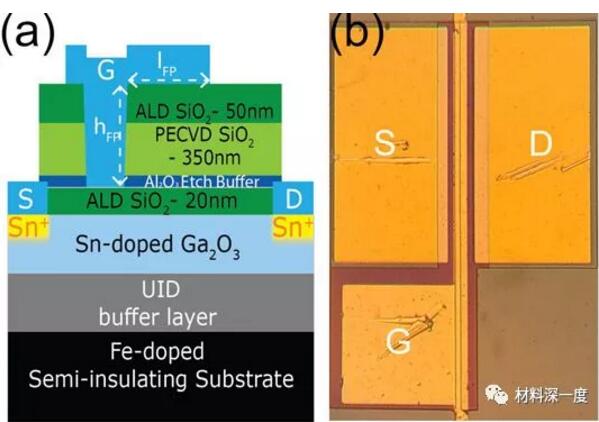
圖 1 β-Ga2O3 MOSFET截面示意圖以及光學顯微鏡下的結構圖像
在電子氟化液(Fluorinert)環境中,該器件的擊穿電壓達到1850V,此時的柵-漏距離為20μm。其他因素保持不變,在空氣環境下,該器件的擊穿電壓只有440V。通過改變柵-漏距離,研究人員發現在Fluorinert環境中下器件的擊穿電壓均為空氣環境下的4倍左右。

圖2 各材料體系電壓與導通電阻的關系(直線為理論值、符號為氧化鎵實驗值)
研究人員將他們研制的器件與其他研究團隊報道的橫向Ga2O3晶體管的性能進行了比較。目前總體性能徘徊在Si基器件的理論極限附近,低于GaN和Ga2O3的預期極限。該團隊期望通過更加精細的器件工藝來提高耐壓水平。此外,Fluorinert液體也會被其他鈍化材料取代。
凡注明為其它來源的信息,均轉載自其它媒體,轉載目的在于傳遞更多信息,并不代表本網贊同其觀點及對其真實性負責。